
|스마트투데이=황태규 기자| 삼성전자가 엔비디아 GTC(GPU Technology Conference)에 참가해 차세대 HBM(고대역폭메모리)4E 실물 칩을 최초로 공개했다.
삼성전자는 3월 16일부터 19일까지(현지시간) 미국 새너제이에서 열리는 엔비디아 GTC에 참가해 차세대 HBM4E 기술력과 베라루빈(Vera Rubin) 플랫폼을 구현하는 메모리 토털 솔루션을 유일하게 공급할 수 있는 역량을 앞세워 글로벌 AI리더십을 한층 강화한다.
이번 전시는 'HBM4 Hero Wall'을 통해 HBM4부터 핵심 경쟁력으로 떠오른 △메모리 △로직 설계 △파운드 리△첨단 패키징을 아우르는 종합반도체 기업(IDM)만의 강점을 부각했다.
삼성전자는 HBM4 양산을 통해 축적한 1c D램 공정 기반의 기술 경쟁력과 삼성 파운드리 4나노 베이스 다이 설계 역량을 바탕으로 차세대 HBM4E 개발을 가속화하고 있으며, HBM4E 실물 칩과 코어 다이 웨이퍼를 최초 공개했다. 삼성전자 HBM4E는 메모리, 자체 파운드리와 로직 설계 역량, 첨단 패키징 기술 등 부문 내 모든 역량을 결집한 최적화 협업을 통해 핀당 16Gbps 속도와 4.0TB/s 대역폭을 지원할 예정이다.
또한, 삼성전자는 영상을 통해 TCB(Thermal Compression Bonding) 대비 열 저항을 20% 이상 개선하고 16단 이상 고적층을 지원하는 HCB(Hybrid Copper Bonding) 기술을 공개하며, 차세대 HBM을 위한 삼성전자의 패키징 기술 경쟁력을 강조했다.
삼성전자 관계자는 "베라루빈 플랫폼에 탑재될 HBM4 칩과 파운드리 4나노 베이스 다이 웨이퍼를 전면에 배치해, 차세대 칩을 구현하는 삼성의 HBM 라인업을 한눈에 확인할 수 있도록 전시를 구성했다. 삼성전자는 종합반도체 기업(IDM)만의 토털 솔루션을 통해 개발 효율을 강화하여 고성능 HBM 시대에서도 성능과 품질을 압도하는 기술 선순환 구조를 구축할 계획"이라고 말했다.

또한, 삼성전자는 이번 전시를 통해 전 세계에서 유일하게 엔비디아 베라루빈 플랫폼의 모든 메모리와 스토리지를 적기에 공급할 수 있는 메모리 토털 솔루션 역량을 부각했다.
삼성전자는 'Nvidia Gallery'를 별도로 구성해 △Rubin GPU용 HBM4 △Vera CPU용 SOCAMM2 △스토리지 PM1763을 Vera Rubin 플랫폼과 함께 전시해, 양사의 협력을 강조했다.
한편, 행사 둘째 날인 3월 17일(현지시간)에는 엔비디아의 특별 초청으로 송용호 삼성전자 AI센터장이 발표에 나서 AI 인프라 혁신을 이끌 엔비디아 차세대 시스템의 중요성과 이를 지원하는 삼성의 메모리 토털 솔루션 비전을 제시할 예정이다.
삼성전자 관계자는 "(송용호 센터장 발표를 통해) 양사의 협력이 단순한 기술 협력을 넘어 AI 인프라 전반으로 확대되고 있음을 보여줄 예정"이라고 밝혔다.


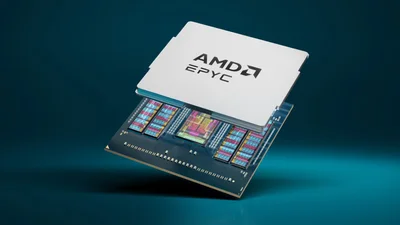
![[애플의 귀환] ②](https://cdn.www.smarttoday.co.kr/w400/q85/article-images/2026-05-13/216958c8-14a3-439a-8066-bf872b861d58.jpg)
![[애플의 귀환] ①](https://cdn.www.smarttoday.co.kr/w400/q85/article-images/2026-05-11/57ba1826-290d-4b84-b293-2b7a3abfebb9.jpg)


댓글 (0)
댓글 작성
댓글을 작성하려면 로그인이 필요합니다.
로그인하기